万垂铭:芯片级封装技术的发展及趋势
2014-12-22 15:38:46 作者:CN_SZLED_2012HJ 来源: 浏览次数:0
半导体照明市场在不断增长,未来几年内,LED在照明领域的渗透率和应用会出现一个黄金增长期。此外,LED在电视机背光、手机、和平板电脑等方面的应用也迎来了爆发式的增长期。
随着LED的不断发展,成本将是LED在通用照明、电视背光、手机背光等各个领域广泛应用的主要障碍。而成本的持续下降将成为推动和占领市场的主要驱动力。此外,上下游产业技术的垂直整合将必然发生,会导致产品形态与性能出现许多变化。而通过产业链的上下游技术整合是降低成本的有效方式之一。在市场需求量迅速提升,对价格下降的压力越来越大的情况下,芯片级尺寸封装技术(Chip Scale Package, “CSP”)的发展就成为趋势。
11月6日,第十一届中国国际半导体照明展览会暨论坛(SSLCHINA2014)之“芯片、器件、封装与模组技术(Ⅰ)”技术分会上,晶科电子(广州)有限公司的万垂铭做了“芯片级封装技术的发展及趋势”的报告。


目前,大量应用的白光LED主要是通过蓝光LED激发黄色荧光粉来实现的,行业内蓝光LED芯片技术路线包含正装结构、垂直结构和倒装结构三个技术方向,倒装芯片由于无需金线互联,且可直接在各种基板表面(PCB、陶瓷等)贴装,因此特别适合芯片级封装(直接在芯片制造阶段就完成了白光封装),形成芯片级的白光LED器件。
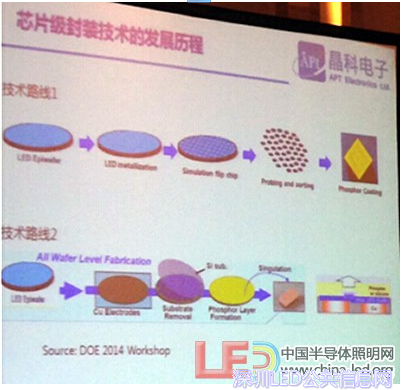
万垂铭表示,倒装芯片技术路线可以完美的实现上下游技术垂直整合,是实现芯片级封装的主流技术路线。LED未来芯片市场三分天下,倒装芯片会是其中之一。
CSP指的是封装体尺寸相比芯片尺寸不大于120%,且功能完整的封装元件。CSP器件的优势在于单个器件的封装简单化、小型化,尽可能降低每个器件的物料成本。“无论何种封装形式,终极将走向芯片级封装CSP的技术路线。”
此外,从芯片级封装产品的应用来看,具有封装体积小,方便设计整合Lens;直接贴合,不需基板;发光角度更大;高密度集成,光色均匀性好;大电流驱动,光输出更大等特点。












